Lead-free solder materials
| Project start: | 11.03.2002 |
|---|---|
| Project end: | 10.03.2007 |
| Programme: | COST |
| Project number: | COST 531 |
| Institute position in the project: | Partner |
| Project leader at the institute: | Pavol Šebo |
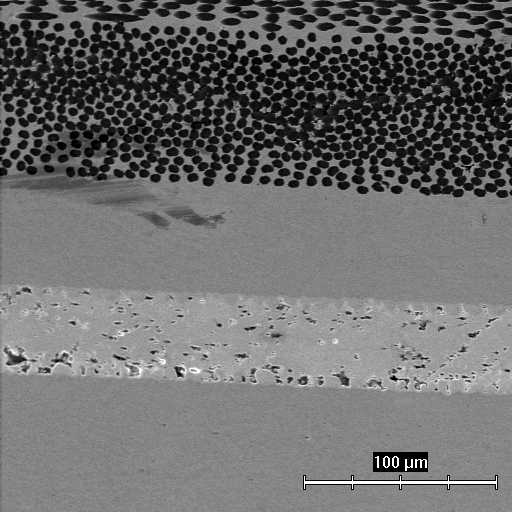 Joining of copper-carbon fibres composite with copper substrate
Joining of copper-carbon fibres composite with copper substrate